WAT,Wafer Acceptance Test(晶圓驗(yàn)收測(cè)試),是用于檢測(cè)芯片制造工藝參數(shù)。??
1.WAT概述
WAT(wafer acceptable test)是一項(xiàng)使用特定測(cè)試機(jī)臺(tái)(分自動(dòng)測(cè)試機(jī)以及手動(dòng)測(cè)試臺(tái))在wafer階段對(duì)特定測(cè)試結(jié)構(gòu)(testkey)進(jìn)行的測(cè)量。
WAT可以反映wafer流片階段的工藝波動(dòng)以及偵測(cè)產(chǎn)線(xiàn)的異常。WAT會(huì)作為wafer是否可以正常出貨的卡控標(biāo)準(zhǔn)。
2.WAT測(cè)試
2.1測(cè)試階段:
WAT測(cè)試可以分為inline WAT、Final WAT。
Inline WAT是在inter-metal階段對(duì)器件做測(cè)試。
Final WAT是在wafer整個(gè)制程完成后對(duì)器件進(jìn)行測(cè)試。
2.2測(cè)試機(jī)臺(tái):
WAT自動(dòng)測(cè)試需要使用特定的測(cè)試機(jī)臺(tái)。主要是Keithley 和 Agilent的測(cè)試機(jī)。測(cè)試機(jī)臺(tái)分為測(cè)試機(jī)柜以及測(cè)試頭。

2.3測(cè)試板卡:
WAT自動(dòng)測(cè)試使用特定的測(cè)試板卡,通過(guò)測(cè)試頭操作測(cè)試板卡進(jìn)行測(cè)試。

WAT手動(dòng)測(cè)試需要使用探針臺(tái),手動(dòng)將測(cè)試探針扎到相應(yīng)的測(cè)試PAD上。
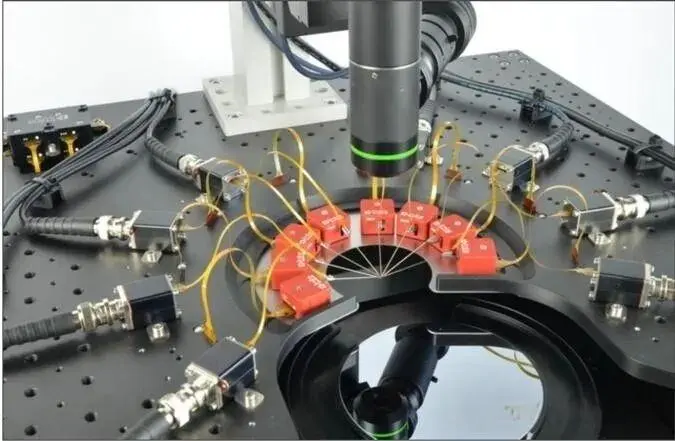
2.4測(cè)試結(jié)構(gòu):
WAT是對(duì)特定的測(cè)試結(jié)構(gòu)(testkey)做測(cè)試。測(cè)試結(jié)構(gòu)(testkey)放置在劃片槽內(nèi)。由測(cè)試探針扎到測(cè)試PAD上進(jìn)行測(cè)試。
為保證測(cè)試一致性以及測(cè)試硬件的重復(fù)利用,器件結(jié)構(gòu)(testkey)都是有統(tǒng)一的PAD數(shù)以及PAD間距。測(cè)試pattern放置在PAD間。具體的標(biāo)準(zhǔn)需要向各家FAB咨詢(xún)。
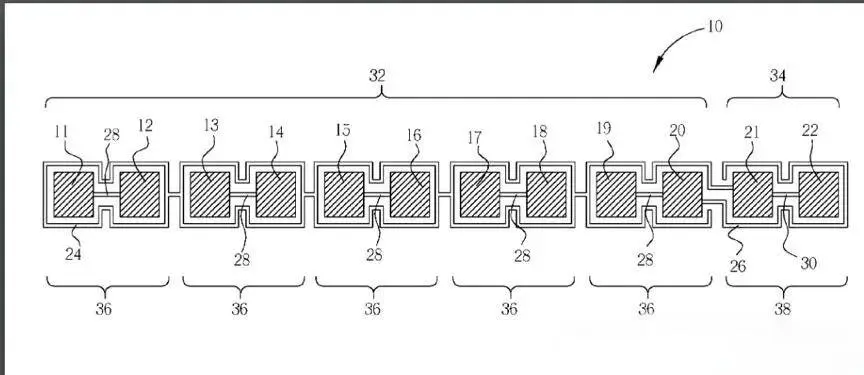
2.5測(cè)試標(biāo)準(zhǔn):

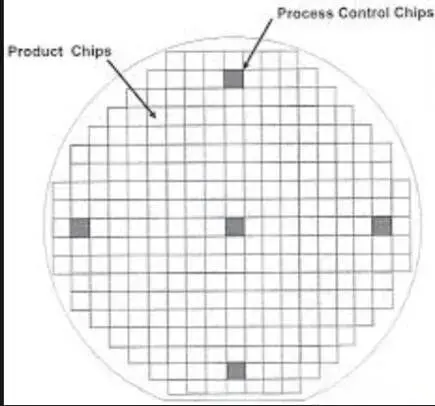
2.6測(cè)試項(xiàng)目:
A. WAT可以測(cè)試電流/電壓/電阻/電容
B. FAB內(nèi)主要的測(cè)試項(xiàng)目:

2.7測(cè)試結(jié)果的分析:
WAT測(cè)試項(xiàng)目可以分為正態(tài)分布項(xiàng)目和非正態(tài)分布項(xiàng)目。
正態(tài)分布項(xiàng)目需要review Cpk,Cpk需要滿(mǎn)足大于1.33。分布的差異來(lái)自于工藝造成的偏差。
非正態(tài)分布項(xiàng)目需要分析長(zhǎng)期測(cè)試結(jié)果的一致性以及異常離散點(diǎn)的原因。


3.WAT測(cè)試的意義:
- 表征產(chǎn)品器件速度?
- 體現(xiàn)工藝能力?
- 監(jiān)控產(chǎn)線(xiàn)工藝波動(dòng)?
- 監(jiān)控產(chǎn)線(xiàn)工藝異常
4.總結(jié):
WAT在工藝開(kāi)發(fā)制程階段是工藝調(diào)整的依據(jù)。WAT在量產(chǎn)階段反應(yīng)的是產(chǎn)線(xiàn)工藝的波動(dòng)。對(duì)于FAB來(lái)說(shuō),WAT是重要的監(jiān)控手段。對(duì)于設(shè)計(jì)來(lái)說(shuō),WAT是驗(yàn)證設(shè)計(jì)的重要參數(shù)。分析利用好WAT對(duì)于產(chǎn)品驗(yàn)證以及量產(chǎn)維護(hù)都有重要的意義。
聯(lián)系我們
- 蘇州同創(chuàng)電子有限公司
- 電話(huà):133 8218 2805
- 官網(wǎng):m.fahuidai.cn
電子二維碼-4.webp)




